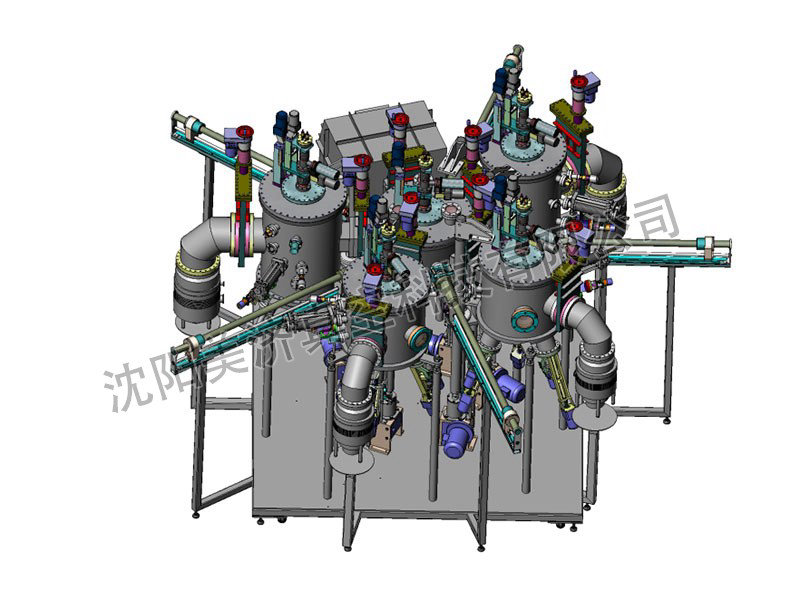
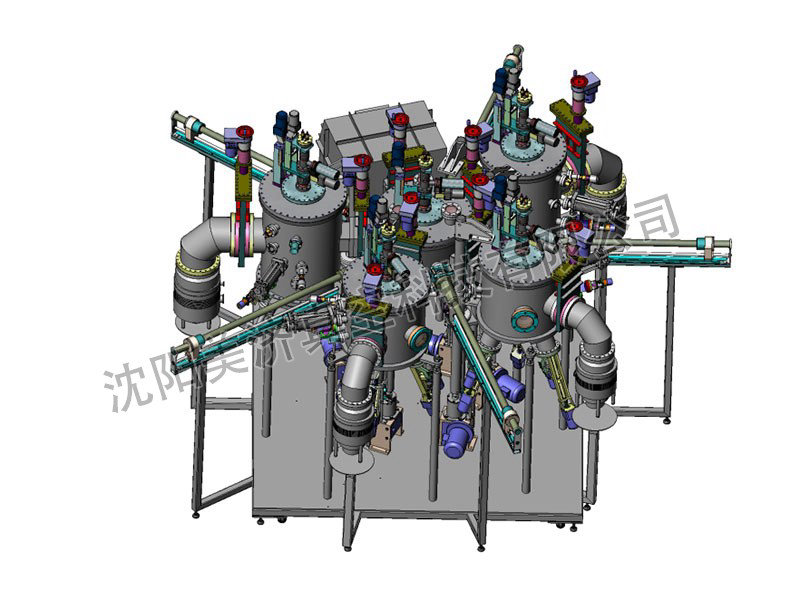
磁控溅射与分子束外延
磁控溅射设备性能:
溅射设备主体均为优质不锈钢制造,耐腐蚀、抗污染、漏率小;设备电控部分采用了先进的检测和控制系统,配置了较先进的PLC触摸编程控制,为用户做多层膜提供了良好的设备功能保证,且保证了设备各功能的稳定和方便操作。性能稳定、可靠;设备布局合理,提高了利用率和稳定性,减少了对环境的干扰;控制面板的设计考虑了美观和适用的结合,使面板操作指示明确,观察舒适、操作方便。
主要技术参数:
1、3支¢100永磁靶(带挡板)一支¢50永磁靶
2、一次可镀¢100衬底样品4块,也可缩小
3、极限真空度:6×10-6 Pa
4、设备总漏放率:关机停泵12小时后,真空度优于10pa
5、衬底可调速自转
6、衬底可加热,室温~350℃
7、恢复工作时间40分钟,真空度可达6×10-4 Pa
附注:磁控溅射的工作原理是指电子在电场E的作用下,在飞向基片过程中与氩原子发生碰撞,使其电离产生出Ar正离子和新的电子;新电子飞向基片,Ar离子在电场作用下加速飞向阴极靶,并以高能量轰击靶表面,使靶材发生溅射。在溅射粒子中,中性的靶原子或分子沉积在基片上形成薄膜,而产生的二次电子会受到电场和磁场作用,产生E(电场)×B(磁场)所指的方向漂移,简称E×B漂移,其运动轨迹近似于一条摆线。若为环形磁场,则电子就以近似摆线形式在靶表面做圆周运动,它们的运动路径不仅很长,而且被束缚在靠近靶表面的等离子体区域内,并且在该区域中电离出大量的Ar 来轰击靶材,从而实现了高的沉积速率。随着碰撞次数的增加,二次电子的能量消耗殆尽,逐渐远离靶表面,并在电场E的作用下最终沉积在基片上。由于该电子的能量很低,传递给基片的能量很小,致使基片温升较低。
磁控溅射是入射粒子和靶的碰撞过程。入射粒子在靶中经历复杂的散射过程,和靶原子碰撞,把部分动量传给靶原子,此靶原子又和其他靶原子碰撞,形成级联过程。在这种级联过程中某些表面附近的靶原子获得向外运动的足够动量,离开靶被溅射出来。

